AI生态系统中的半导体制造设备
TDK将与AI(人工智能)相关的广泛产品和产业领域定义为“AI生态系统”。TDK的技术被用于各种设备,包括数据中心内的AI服务器和存储设备,这对于生成式AI至关重要,还应用于AR眼镜、智能手机和自动驾驶汽车等各种设备。
其中,半导体承担着生成式AI的数据处理这一核心功能,其制造装置也应用了TDK的技术。

AI发展的挑战是“AI半导体”制造技术的进化
近年来,随着AI的突飞猛进,“AI半导体*1”逐渐取代传统的通用半导体,成为人们关注的焦点。AI半导体是专门用于AI运算处理的半导体的总称。“ChatGPT”等生成式AI可以同时高速处理大量数据,因此需要使用专门针对这些性能的AI半导体。因此,生产这些半导体制造设备也需要进一步的进化。
半导体的制造工序大致分为“前工序”和“后工序”两种。前工序主要是指在称为硅晶圆的薄圆盘上形成半导体电路的过程。另一方面,后工序主要是将晶圆切割成芯片,进行外部保护和布线后进行封装,将它们组装成完整的半导体产品的过程。
TDK应用在电子元件制造中积累的机电一体化*2技术,提供最先进的FA设备,在AI半导体制造的前工序和后工序中分别发挥着重要作用。FA设备是“Factory Automation”的缩写,是用于工厂和生产线自动化的设备和系统的统称。
TDK的FA设备支持半导体制造
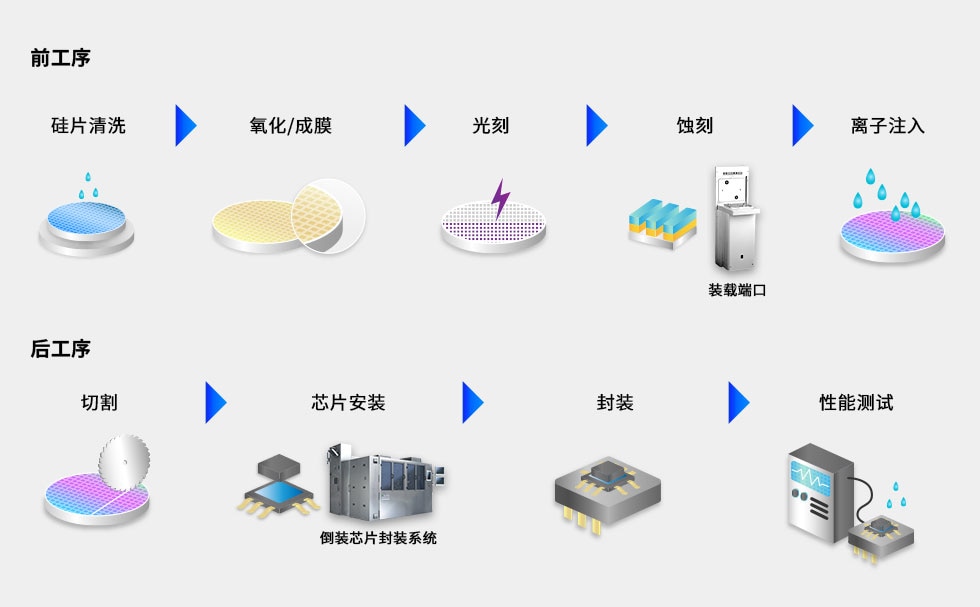
支持晶圆电路图案微细化的“加载端口”洁净技术
在AI半导体制造的前工序中,随着电路图案的日益精细化,对晶圆的污染对策提出了从未有过的严格要求。由于提高整个工厂的洁净度需要大规模的设备投资,近年来的主流是将晶圆存储在密封的FOUP(Front Opening Unified Pod)吊舱内并自动运输的“微环境方式”*3。将该FOUP内的晶圆放入制造设备中或从中取出的装置就是“加载端口”。
TDK开发的“TAS300”加载端口可准确控制和输送晶圆,同时保持FOUP内部的洁净环境。它是基于在电子元件自动贴片机等方面积累的FA技术和硬盘磁头制造中不可缺少的洁净室技术开发的。它还支持符合SEMI*4标准的FOUP,获得了半导体制造商和半导体器件制造商的高度评价。

“TAS300”加载端口
最新“倒装芯片封装系统”支持实现2.5维/三维封装
在AI半导体制造的后工序中,由于前工序中电路形成的微型化已接近极限,因此需要封装技术的进化。半导体封装是将芯片连接到印刷电路板上并使其发挥电子设备功能的工序,目前主流是将芯片平面排列在电路板上的“二维封装”。
另一方面,“2.5维/三维封装*5”技术通过将多个半导体芯片以高密度集成在基板或堆叠结构上,从而实现更高的密度、更快的速度并节省空间。这种高维封装技术被认为是未来人工智能半导体制造中最受欢迎的关键技术之一。
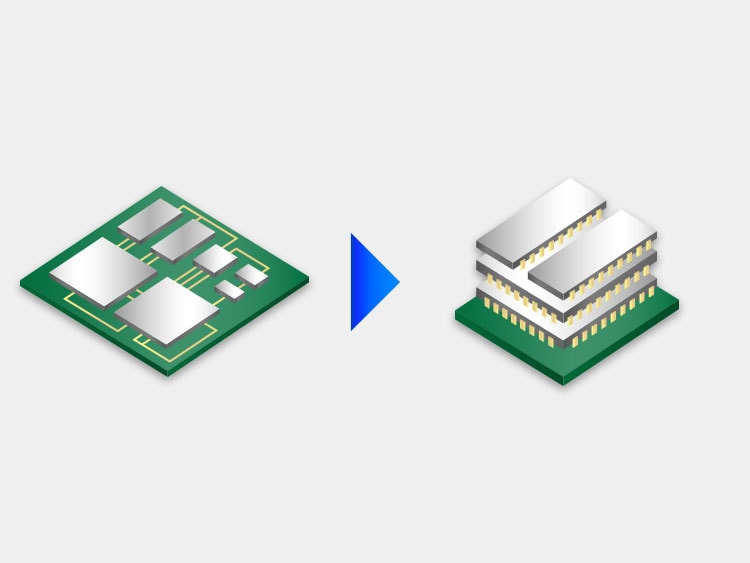
二维封装和三维封装的对比(示意图)

“AFM18”倒装芯片封装系统
TDK于2024年新开发的“AFM18”倒装芯片封装系统是实现这种2.5维/3维封装的理想选择。该系统是通过翻转(倒装)芯片,将表面的电极(凸块)与基板直接接合的装置,“AFM18”最大可支持650mm见方的大型基板,实现了XY方向±1μm、θ方向0.01度的极高定位精度。该系统具有高灵活性和超高精度,支持2.5维/三维封装的实现。
还提供了前工序和后工序解决方案
作为一家电子元件制造商,TDK秉承“优质的产品是由优质的制造设备制造出来的”的理念,在开发自身独特的施工方法的同时,还不断磨练生产技术以实现这一理念。TDK的FA业务就是利用这种生产技术将其商业化的。自1976年开发电子元件自动贴片机“Abisart”以来,已有约50年的历史,始终致力于开发和提供反映生产现场需求的产品。这种方法只有TDK这家电子元件制造商才能做到,今后也将提供解决半导体制造课题的设备。
此外,“AFM18”倒装芯片封装系统是以与TDK的加载端口和EFEM*6的协作为前提开发的,可以构筑全自动的倒装芯片键合解决方案。这能够有助于提高AI半导体的生产效率。TDK将向全球提供前工序和后工序中的广泛知识和技术,为前沿半导体制造的未来发展提供支持。
TDK将通过提供先进的FA设备来支持AI半导体制造设备的发展,拓展AI的可能性。除了“TAS300”加载端口和“AFM系列”倒装芯片封装系统之外,还推出了高精度分配器等产品。详情请访问产品中心。
术语表
- AI半导体:例如,擅长数据并行处理的GPU(Graphics Processing Unit)、可以通过程序变更逻辑电路配置的FPGA(Field Programmable Gate Array)、AI处理专用芯片ASIC(Application Specific Integrated Circuit)等。
- 机电一体化:“机械(机械工程)”和电子学(电子工程)的组合词,是利用电子的力量控制设备的技术。
- 微环境:半导体制造设备中用于保护晶圆等的小型封闭空间。它可以防止微粒和污染物的进入,保持洁净的环境。
- SEMI:半导体制造设备和FA设备的国际标准,旨在确保产品的兼容性和可靠性。
- 2.5维/三维封装:2.5维封装通过将多个芯片紧密地放置在基板上,而三维封装通过堆叠芯片来实现比以往更高的密度和速度。
- EFEM:Equipment Front End Module(设备前端模块)的缩写。它是一种在半导体制造工艺中,在存储FOUP等晶圆的容器和工艺设备之间传输晶圆的装置。












